电介质
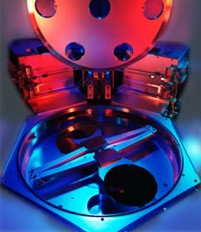
成千上万的电解质薄膜被用于光学,半导体,以及其它数十个行业, 而Filmetrics的仪器几乎可以测量所有的薄膜。常见的电介质有:
-
二氧化硅 – 最简单的材料之一, 主要是因为它在大部分光谱上的无吸收性 (k=0), 而且非常接近化学计量 (就是说,硅:氧非常接近 1:2)。 受热生长的二氧化硅对光谱反应规范,通常被用来做厚度和折射率标准。 Filmetrics能测量3nm到1mm的二氧化硅厚度。
-
氮化硅 – 对此薄膜的测量比很多电介质困难,因为硅:氮比率通常不是3:4, 而且折射率一般要与薄膜厚度同时测量。 更麻烦的是,氧常常渗入薄膜,生成一定程度的氮氧化硅,增大测量难度。 但是幸运的是,我们的系统能在几秒钟内 “一键” 测量氮化硅薄膜完整特征!
联络 Filmetrics 讨论您的测量需要。
Filmetrics 提供免费测量 - 一般1-2 天得到结果。
请现在就跟我们联系
搜索应用
-
非晶多晶硅
测量厚度, 结晶, 以及各种形式非晶硅和多晶硅的折射率和消光系数。
APPLICATIONS_amorphous-poly-silicon_FilterKeywords
-
CMP
我们的 F80 厚度成像产品用于测量氧化物、STI 和金属化学机械研磨加工。
APPLICATIONS_cmp_FilterKeywords
-
电介质
Filmetrics库存成千上万种工业用电介质薄膜测量仪器。
APPLICATIONS_dielectrics_FilterKeywords
-
硬涂层厚度
Filmetrics 系统广泛用于汽车工业验证硬薄膜和底漆厚度。
APPLICATIONS_hardcoat-thickness_FilterKeywords
-
集成电路故障分析
F3-sX 广泛用于芯片产业测量硅背面薄化。
APPLICATIONS_failure-analysis_FilterKeywords
-
铟锡氧化物与透明导电氧化物
Filmetrics独有的分析算法可以一键测量透明导电氧化物 (TCO)厚度,折射率,和消光系数。
APPLICATIONS_ito_FilterKeywords
-
医疗设备
测量血管成型球囊、支架、植入件以及其它很多涂层厚度。
APPLICATIONS_biomedical_FilterKeywords
-
金属厚度测量
测量达50纳米(nm)的金属膜厚度,折射率,和消光系数。
APPLICATIONS_metal_FilterKeywords
-
有机发光显示器
测量萘联苯胺,三喹啉铝,聚 乙烯基,聚 己基噻吩,以及可溶性特氟隆等薄膜的厚度和折射率。
APPLICATIONS_oled_FilterKeywords
-
眼科设备涂层
F10-AR 测量反射率和颜色,以及减反射涂层和硬涂层厚度。
APPLICATIONS_ophthalmic_FilterKeywords
-
聚对二甲苯涂层
只要把聚对二甲苯涂层样本放在F3-CS平台上,就可以测量厚度!
APPLICATIONS_parylene_FilterKeywords
-
光刻胶
我们已经测量了几十种光刻胶,我们能生成您需要的任何光刻胶折射率文件。
APPLICATIONS_photoresist_FilterKeywords
-
多孔硅
测量多孔硅薄膜厚度,多孔性,折射率,和消光系数。
APPLICATIONS_porous-silicon_FilterKeywords
-
制程薄膜
Filmetrics提供测量半导体制程薄膜的全系列产品。
APPLICATIONS_process-films_FilterKeywords
-
折射率和消光系数
测量波长200纳米(nm)到1700纳米(nm)的折射率和消光系数。
APPLICATIONS_refractive-index_FilterKeywords
-
硅晶圆薄膜
测量达2毫米厚晶圆的台式,测绘,和生产系统。
APPLICATIONS_si-wafers_FilterKeywords
-
太阳光伏
测量碲化镉, 硫化镉, 铜铟硒化镓, 无定形硅,透明导电氧化膜, 减反射层, 等等。。。
APPLICATIONS_solar_FilterKeywords
-
半导体教学实验室
已经有五十多台 Filmetrics 的 F20 用于大学半导体制造教学实验室。
APPLICATIONS_teaching-labs_FilterKeywords
-
卷式涂层
Filmetrics系统广泛用于在线测量聚合物薄膜厚度领域。
APPLICATIONS_web-coatings_FilterKeywords
